Imec odkrywa sposób na zwiększenie wydajności fotolitografii EUV: wtrysk tlenu podczas wygrzewania po naświetlaniu fotorezystu metalowo-tlenkowego
Wyniki badań pokazują, że kontrolowanie składu gazu, a zwłaszcza poziomu tlenu, podczas krytycznych etapów litografii radykalnie optymalizuje czułość powłoki fotorezystu metalowo-tlenkowego MOR w przypadku nowej generacji fotolitografii High-NA EUV.
LEUVEN (Belgia), 25 LUTEGO 2026 r. W tym tygodniu podczas konferencji SPIE Advanced Lithography + Patterning Conference 2026 imec, centrum badań i innowacji w dziedzinie zaawansowanych technologii półprzewodnikowych, wykazał, że precyzyjna kontrola składu gazów podczas etapów litografii EUV może pomóc w zminimalizowaniu wymaganej dawki naświetlania, umożliwiając w ten sposób zwiększenie ilości płytek w tym samym czasie. W szczególności, uzyskano lepszą odpowiedź na dawkę światła dla fotorezystów metalowo-tlenkowych (MOR), gdy etap wygrzewania po naświetlaniu EUV jest przeprowadzany przy podwyższonym stężeniu tlenu.
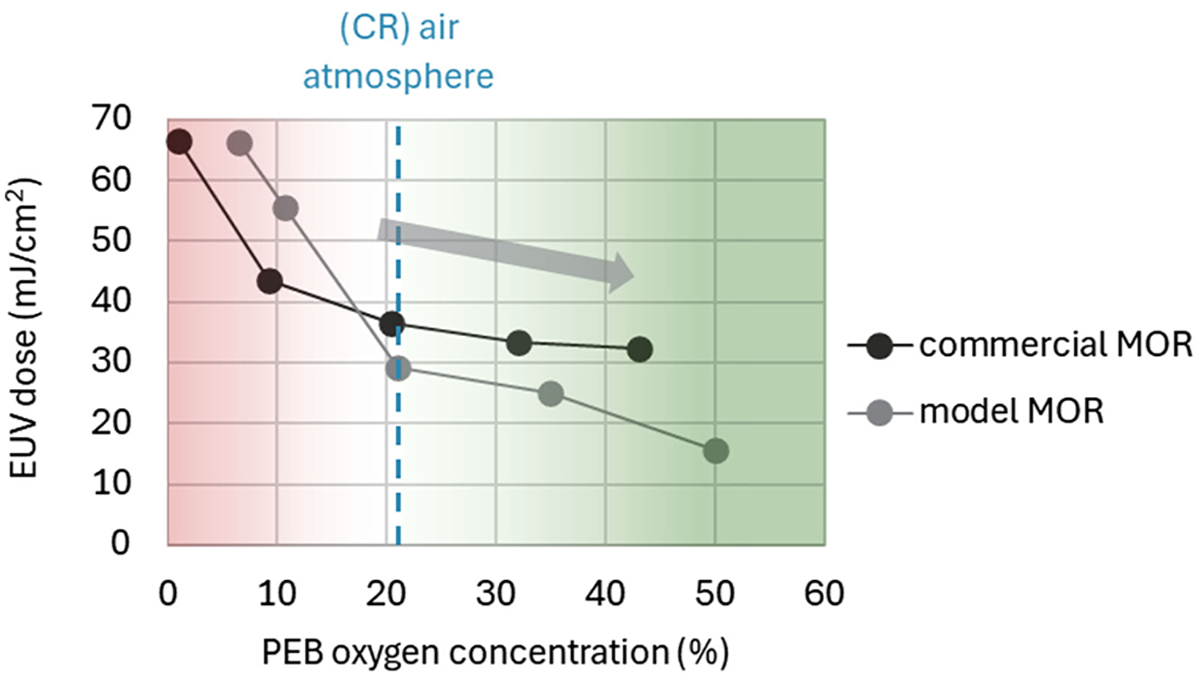
Wykres przedstawiający wpływ wtrysku tlenu na dawkę EUV wymaganą do drukowania zarówno w przypadku modelu, jak i komercyjnego MOR. W przypadku stężenia tlenu powyżej 21% (tlen w atmosferze powietrza) stwierdzono znaczne zmniejszenie dawki EUV.
Grzegorz Kamiński: Rezysty metalowo-tlenkowe (MOR) wyróżniają się swoimi wyjątkowymi właściwościami chemicznymi i fizycznymi. Zbudowane z klastrów metalowo-tlenkowych, materiały te charakteryzują się wysoką odpornością na trawienie i doskonałą stabilnością mechaniczną. W przeciwieństwie do konwencjonalnych rezystów organicznych, MOR oferują doskonałą rozdzielczość i zmniejszoną chropowatość krawędzi linii, co jest kluczowymi cechami dla technologii o rozmiarach charakterystycznych poniżej 10 nm. Nieorganiczna natura tych rezystów przyczynia się do ich wytrzymałości, dzięki czemu są one mniej podatne na problemy występujące w przypadku tradycyjnych rezystów.
Wygrzewanie po naświetlaniu EUV (PEB – post-exposure bake ) to dodatkowy proces przed wywołaniem fotorezystu. Dla klasycznych fotorezystów organicznych proces wygrzewania jest już po wywołaniu i nazywa się procesem Hard-bake który służy do podgrzania płytki np. krzemowej pokrytej już wywołanym fotorezystem do temperatury w zakresie 120-150 °C. Po tym procesie już nie będziemy mogli usunąć pozostałości fotorezystu w niepożądanych miejscach. Można to porównać do utwardzenia “lakieru”. Fotorezyst zyskuje także odporność na kolejne procesy fizyko-chemiczne. Musi dać nam gwarancję że w kolejnych procesach usuniemy warstwę np. tlenku krzemu SiO2 w tym miejscu gdzie chcemy, a fotorezyst będzie barierą dla wytrawiacza SiO2.
Rezysty metalowo-tlenkowe (MOR) stały się wiodącymi kandydatami do zastosowań w zaawansowanej litografii EUV, oferując lepszą rozdzielczość, zmniejszoną chropowatość krawędzi linii i dobrą relację dawki do rozmiaru EUV w porównaniu z rezystami chemicznie wzmacnianymi (CAR). Ich lepsza zdolność przenoszenia wzoru w przypadku małych elementów i cienkich warstw rezystywnych sprawia, że są one szczególnie atrakcyjne dla warstw metalicznych o najwyższej rozdzielczości, naświetlanych litografią EUV o wysokiej gęstości optycznej (High NA).
Grzegorz Kamiński: Rezysty chemicznie wzmacniane (CAR) stosuje się głównie w fotolitografii DUV np. gdzie długość fali naświetlania wynosi 193 lub 248 nm. Podobnie jak klasyczne fotorezysty, fotorezysty CAR to złożone związki organiczne. Wspomniane wzmocnienie ( A – jak amplification) polega na tym że światłoczułość tych fotorezystów jest większa i pojedynczy foton może wywołać rozkład setek, jak nie tysięcy, wiązań chemicznych czułych na światło w podanym wyżej zakresie.
Imec dowodzi obecnie, że odpowiedź na dawkę światła dla fotorezystów MOR można dodatkowo poprawić poprzez podniesienie stężenia tlenu powyżej poziomu atmosferycznego podczas etapu wygrzewania po naświetlaniu litografii EUV – krytycznego etapu obróbki cieplnej po naświetlaniu rezystu EUV i przed jego wywołaniem.
Wzrost szybkości naświetlania o 15–20%
– Obserwujemy o 15-20% większą czułość i podatność na zmianę właściwości fotorezysu po naświetleniu przy zwiększeniu stężenia tlenu z 21% do 50% w atmosferze podczas wygrzewania po naświetlaniu (PEB). Tendencja ta jest obserwowana zarówno w przypadku laboratoryjnych, jak i komercyjnych materiałów MOR. To odkrycie po raz pierwszy pokazuje, że staranna kontrola składu gazu podczas kluczowych etapów litografii może znacząco obniżyć wymaganą dawkę promieniowania EUV, bezpośrednio zwiększając przepustowość skanera EUV i redukując koszty procesu. To dopiero pierwszy wynik narzędzia BEFORCE: kontrolowany skład gazu zapewnia dodatkowe możliwości badania źródeł wpływu środowiska na zmienność właściwości materiałów MOR. Producenci urządzeń mogą wykorzystać te informacje jako wskazówki do dostosowania swoich procesów w celu zwiększenia przepustowości i stabilności litografii EUV – powiedział Ivan Pollentier, starszy badacz w imec.
Lepsze wyniki dzięki BEFORCE
Unikalne narzędzie badawczego zostało opracowane przez imec w celu zbadania wpływu środowiska na stabilność wymiarów krytycznych (CD) i wydajność materiałów MOR.
– W komercyjnych urządzeniach EUV, płytki pokryte powłoką rezystywną są naświetlane w próżni, a następnie przenoszone do urządzenia gdzie się nagrzewane po naświetlaniu, ale proces jest wykonywanych w normalnych warunkach atmosferycznych. Nasze narzędzie BEFORCE naśladuje te operacje, ale przenoszenie płytki i wygrzewanie po naświetlaniu są izolowane od atmosfery pomieszczenia czystego i mogą być przeprowadzane w precyzyjnie kontrolowanych środowiskach, na które pozwalają systemy dozowania i mieszania gazów. Ta unikalna zdolność, w połączeniu ze zintegrowanym pomiarem prędkości procesu naświetlania, była kluczowa dla odkrycia roli tlenu we wzmacnianiu odpowiedzi na dawkę promieniowania MOR – oznajmił Kevin Dorney, kierownik zespołu badawczo-rozwojowego w imec.

Zdjęcia narzędzia BEFORCE, skrót od „Bake and EUV system with FTIR and Outgas measurement for Resist evaluation in Controlled Environment” (System wygrzewania i EUV z pomiarem FTIR i odgazowaniem do oceny fotorezystu w kontrolowanym środowisku).
Aby optymalnie wykorzystać pozytywny wpływ składu gazów na wydajność rezystu MOR, niezbędne jest głębsze zrozumienie mechanizmu chemicznego zachodzącego podczas wygrzewania rezystu po naświetlaniu (proces PEB). Trwają eksperymenty mające na celu korelację wydajności rezystu MOR z obserwacjami zmian chemicznych podczas wygrzewania – rejestrowanymi przez zintegrowany spektrometr w podczerwieni z transformacją Fouriera – w zmiennych warunkach środowiskowych. Planowane rozszerzenie narzędzia BEFORCE o zaawansowane funkcje metrologiczne umożliwi firmie imec uzyskanie jeszcze bardziej znaczących wyników.

BEFORCE może być wykorzystywane w szerszym zakresie do badania zarówno fotorezystów MOR, jak i CAR i jest dostępny dla partnerów imec w celu oceny frezystu | źródło: imec
Zaprezentowane osiągnięcia i wstępne wnioski fundamentalne zostały przedstawione w dwóch artykułach opublikowanych podczas konferencji SPIE Advanced Lithography + Patterning Conference 2026:
- Artykuł 13983-36 – „Unraveling a new dose reduction strategy for metal oxide resist by the atmospheric environment of the post exposure bake”, I. Pollentier i in.
- Artykuł 13983-50 – „Chemical origins of environmental modifications to the lithographic chemistry of MOR resists”, K. Dorney i in.
Prace te zostały częściowo umożliwione dzięki linii pilotażowej NanoIC, której zakup i eksploatacja są finansowane wspólnie przez Chips Joint Undertaking, w ramach programów Unii Europejskiej „Digital Europe” (101183266) i „Horizon Europe” (101183277), a także przez uczestniczące państwa: Belgię (Flandria), Francję, Niemcy, Finlandię, Irlandię i Rumunię.
Imec to centrum badań i innowacji w dziedzinie zaawansowanych technologii półprzewodnikowych. Wyposażone jest w najnowocześniejszą infrastrukturę badawczo-rozwojową. Zatrudnia ponad 6500 specjalistów w zakresie półprzewodników i systemów sztucznej inteligencji, fotoniki krzemowej, łączności i czujników.
Zaawansowane badania imec przyczyniają się do przełomowych osiągnięć w wielu branżach, w tym w informatyce, służbie zdrowia, motoryzacji, energetyce, infotainment, przemyśle, agrobiznesie i bezpieczeństwie. Poprzez IC-Link imec prowadzi firmy przez każdy etap tworzenia chipów – od wstępnej koncepcji do produkcji na pełną skalę – dostarczając rozwiązania dostosowane do najbardziej zaawansowanych potrzeb w zakresie projektowania i produkcji.
Imec współpracuje z globalnymi liderami w całym łańcuchu wartości półprzewodników, a także z firmami technologicznymi, start-upami, środowiskiem akademickim i instytucjami badawczymi we Flandrii i na całym świecie. Imec ma siedzibę w Leuven w Belgii i posiada ośrodki badawcze w Belgii, Niemczech, Holandii, Włoszech, Wielkiej Brytanii, Hiszpanii i Stanach Zjednoczonych, a także przedstawicielstwa na trzech kontynentach. W 2024 r. imec odnotował przychody w wysokości 1,034 mld EUR.





 Imec przedstawia 7-bitowy przetwornik analogowo-cyfrowy typu slope o częstotliwości 175 GS/s z masywnym przeplotem czasowym
Imec przedstawia 7-bitowy przetwornik analogowo-cyfrowy typu slope o częstotliwości 175 GS/s z masywnym przeplotem czasowym  NanoIC – pilotażowa linia produkcyjna układów scalonych poniżej 2 nm – oficjalnie otwarta w belgijskim imec
NanoIC – pilotażowa linia produkcyjna układów scalonych poniżej 2 nm – oficjalnie otwarta w belgijskim imec  Europractice 2.0 – usługi projektowania i prototypowania chipów – finansowane przez UE do września 2028 r.
Europractice 2.0 – usługi projektowania i prototypowania chipów – finansowane przez UE do września 2028 r. 




