Imec zainstalował w linii pilotażowej NanoIC najbardziej zaawansowany na świecie system EUV o wysokim współczynniku apertury (NA)
Belgijskie centrum badań i innowacji w dziedzinie zaawansowanych technologii półprzewodnikowych, ogłosiło 18 marca instalację systemu ASML EXE:5200 High NA EUV, najbardziej zaawansowanego narzędzia litograficznego dostępnego obecnie na rynku, w budowanej linii pilotażowej NanoIC w Leuven. Dzięki temu imec umocni swoją pozycję jako platforma startowa branży w erę ångströmów, zapewniając swojemu globalnemu ekosystemowi partnerów wczesny dostęp do technologii skalowania chipów nowej generacji.

Zintegrowany bezpośrednio z kompleksowym zestawem narzędzi i materiałów do wzorcowania oraz metrologii, system litografii EUV o wysokim współczynniku NA, umożliwi imec i jego partnerom z ekosystemu osiągnięcie wydajności niezbędnej do pionierskiego wdrożenia technologii logicznych poniżej 2 nm oraz pamięci o wysokiej gęstości, które będą napędzać szybki rozwój zaawansowanej sztucznej inteligencji i obliczeń o wysokiej wydajności.
– Ostatnie dwa lata stanowiły ważny rozdział w historii litografii EUV o wysokim współczynniku NA (0,55 NA). Imec i ASML połączyły siły z ekosystemem w ramach wspólnego laboratorium w Veldhoven (Holandia). Wraz z instalacją systemu litografii EUV o wysokim współczynniku NA EXE:5200 w naszym pomieszczeniu czystym 300 mm w Leuven (Belgia), dążymy do wprowadzenia technologii wzorcowania EUV na skalę istotną dla przemysłu oraz do opracowania zastosowań wzorcowania EUV o wysokim współczynniku NA nowej generacji. Niezrównana rozdzielczość, ulepszona wydajność oraz nowy magazyn płytek, który poprawia stabilność procesu i przepustowość, zapewnią naszym partnerom decydującą przewagę w przyspieszeniu rozwoju technologii chipów poniżej 2 nm. W miarę jak branża wkracza w erę ångströma, litografia EUV o wysokim współczynniku NA stanie się podstawową technologią – powiedział Luc Van den hove, dyrektor generalny imec.
Strategiczne partnerstwo imec z firmą ASML
To przełomowe osiągnięcie stanowi kluczowy element pięcioletniego partnerstwa strategicznego między imec a firmą ASML, wspieranego przez UE (wspólne przedsięwzięcie Chips oraz IPCEI), rząd flamandzki oraz rząd holenderski.
– Jako integralna część finansowanej przez UE pilotażowej linii produkcyjnej NanoIC, urządzenie to ma odegrać kluczową rolę w umacnianiu pozycji Europy jako lidera w dziedzinie zaawansowanych badań i rozwoju półprzewodników w nadchodzących dziesięcioleciach – dodał Luc Van den hove.
Posiadanie w clean roomie systemu litografii EUV ASML EXE:5200 High NA zdecydowanie pozycjonuje imec jako najbardziej kompleksowe środowisko rozwoju zaawansowanych chipów. Głęboka współpraca ekosystemowa imec z wiodącymi producentami, dostawcami sprzętu, materiałów i fotorezystów, z firmami produkującymi maski oraz ekspertami w dziedzinie metrologii, pozwoli przyspieszyć cykle uczenia się i zwiększyć stabilność procesów. Celem jest opracowanie i zademonstrowanie najnowocześniejszych metod wzorcowania dla technologii urządzeń logicznych i pamięciowych nowej generacji, które będą kształtować przyszłość zaawansowanych obliczeń i sztucznej inteligencji w nadchodzących latach.

Źródło: imec
– Zainstalowanie przez imec systemu EXE:5200 stanowi ważny krok w kierunku ery ångströma. Wspólnie przyspieszamy rozwój technologii EUV o wysokim współczynniku NA dla kolejnych generacji zaawansowanych pamięci i układów obliczeniowych – oznajmił Christophe Fouquet, dyrektor generalny ASML.
Imec przewiduje, że system litograficzny EXE:5200 High NA EUV zostanie w pełni zakwalifikowany do czwartego kwartału 2026 roku. W międzyczasie wspólne laboratorium litograficzne ASML-imec High NA EUV w Veldhoven będzie nadal realizować działania badawczo-rozwojowe w zakresie High NA EUV dla imec i jego partnerów ekosystemowych.





 Imec tworzy konsorcjum uniwersyteckie zajmujące się chipami nowej generacji
Imec tworzy konsorcjum uniwersyteckie zajmujące się chipami nowej generacji 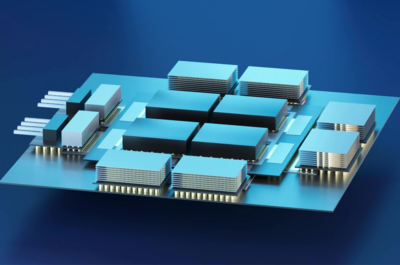 NanoIC otwiera dostęp do pierwszych w historii hybrydowych połączeń między-układowych; zestaw do projektowania (PDK) połączeń typu RDL i D2W
NanoIC otwiera dostęp do pierwszych w historii hybrydowych połączeń między-układowych; zestaw do projektowania (PDK) połączeń typu RDL i D2W  Imec odkrywa sposób na zwiększenie wydajności fotolitografii EUV: wtrysk tlenu podczas wygrzewania po naświetlaniu fotorezystu metalowo-tlenkowego
Imec odkrywa sposób na zwiększenie wydajności fotolitografii EUV: wtrysk tlenu podczas wygrzewania po naświetlaniu fotorezystu metalowo-tlenkowego 




